BALL GRID ARRAY (BGA)
The Gold Standard for High Density IC Packaging
Maximizing performance, minimizing space.
What is a Ball Grid Array (BGA)?
A Ball Grid Array (BGA) is a type of IC packaging that uses solder balls arranged in a grid pattern on the underside of the package. This design replaces traditional leads and allows for more pins in a compact area, making it ideal for advanced electronic applications.


Developed to improve electrical and thermal performance compared to traditional IC packages with leads.
Key Features of BGA
Compact Design


Supports high pin density in minimal space.




High Performance
Improved electrical and thermal properties.
Excellent mechanical strength and low resistance.
Reliable Connections
Innovative Solutions for Modern Technology








Microprocessors and GPUs: Powering computing and graphical applications.
Memory Modules: Found in DRAM, Flash, and SSDs.
Networking Devices: Routers, switches, and communication equipment.
Automotive and Industrial Systems: Used in control units and embedded systems.
Variants of BGA Packaging
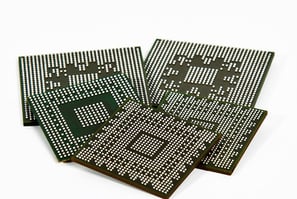
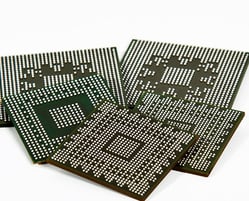
uBGA (Micro BGA)
Smaller solder ball pitch for compact devices.


TBGA (Thin BGA)
Thinner profile for low-height designs.


PBGA (Plastic BGA)
Cost-effective solution for high-volume production.


CBGA (Ceramic BGA)
Enhanced thermal and mechanical properties.
Innovation
Leading IC packaging solutions for semiconductor industry.
Expertise
+91 86601 60366
© 2024. All rights reserved.
